신한금융투자_반도체_200902
Tech를 이해해야 전략이 보인다

④ 후공정 기술 변화
후공정 기술 변화를 다루기 앞서 패키징 공정이 어떻게 이루어지는지 먼저 알아보겠습니다!
후공정에선 패키징이 가장 중요하기 때문에 기본적인 과정과 용어를 알아두시면 도움이 많이 됩니다.
패키징 공정은
1. 칩을 먼저 패키징 기판(Substrate)에 연결하고,
2. 그 기판을 다시 메인보드(=시스템 보드, PCB 보드)에 연결합니다.
메인보드는 우리가 아는 그 컴퓨터 부품 메인보드입니다. 칩을 메인보드에 연결해야 컴퓨터나 스마트폰의 부품으로써 실제 사용을 할 수 있게 됩니다. 그전에 기판이 중간 다리 역할을 해준다고 보시면 됩니다.

이때 칩 - 기판을 연결하는 방식에는 1. 와이어 본딩 방식과 2. 플립 칩 방식이 있습니다.

와이어 방식은 칩과 기판 사이를 전선줄로 연결하는 것이고,
플립 칩 방식은 칩을 반대로 뒤집어, 칩 위에 튀어나온 부분(범프)을 만들어 연결하는 것입니다.
범프를 이용하면 전선보다 더 많은 면적을 사용하기 때문에 전력 효율이 더 좋아집니다.
다음,
기판-보드를 연결할 때는 1. 리드 프레임 방식과 2. 솔더 볼(Package PCB) 방식이 있습니다.

리드 프레임은 리드(lead)로 연결하고, 솔더 볼 방식은 범프와 비슷하게 선이 아닌 동그란 전극으로 연결합니다. 옛날에는 리드프레임을 썼으나 현재는 솔더 볼을 많이 쓰고 있습니다.
- FO vs FI, WLP vs PLP?
FO-WLP, FO-PLP와 같은 용어들을 많이 들어보셨을 겁니다.
FI는 칩과 기판의 크기가 같은 것을 말하고, FO는 칩보다 기판이 더 큰 것을 말합니다.
FO에서는 같은 솔더볼 이어도 볼이 더 많이 들어가기 때문에 전력 효율이 더 좋아집니다.
FI보다 FO가 더 발전된 기술이라고 보시면 되겠습니다.
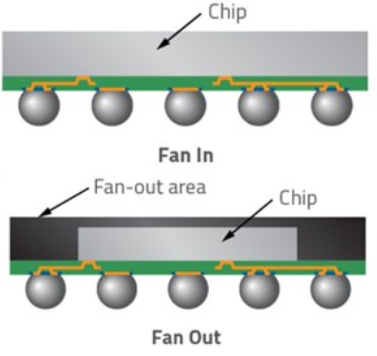
패키징은 하는 방법에 따라 DLP(Die Level Package), WLP(Wafer Level Package), PLP(Panel Level Package) 방식으로 나눌 수 있습니다.
웨이퍼 위에 올려진 반도체 칩들을 다이(die)라고 부릅니다. 이 다이를 먼저 다 자르고 각각 패키징을 하면 DLP가 되고,
웨이퍼를 자르지 않고 그대로 통째로 패키징을 하면 WLP방식입니다. WLP로 하게 되면 기능과 공간을 최적화하여 패키지의 크기를 줄일 수 있고, RDL이란 걸 형성하기 때문에 기판(Substrate)이 필요 없어집니다.
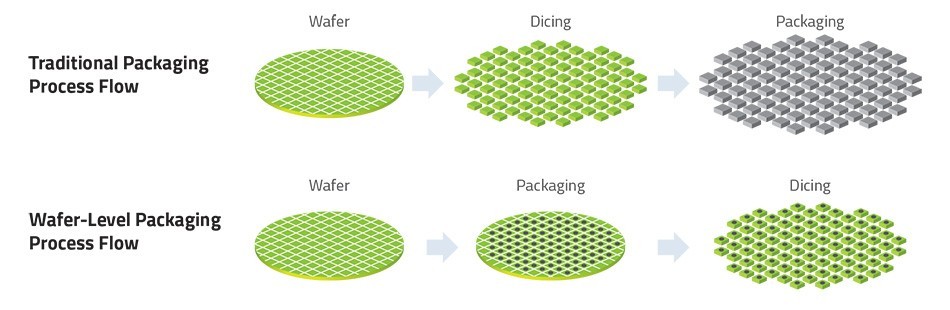
PLP는 원형의 웨이퍼 대신에 사각형 패널에서 공정을 진행합니다. PLP로 하면 WLP처럼 동그랗게 했을 때보다 잃는 부분이 적어서 면적 사용효율이 높아집니다.

▶ TSMC는 FO-WLP 기술을 개발해서 양산화에 성공했고, 삼성전자는 첨부터 FO-PLP를 개발하는 노선을 택해 양산을 준비하고 있습니다. PLP는 기존 반도체 공정과 다르기 때문에 새로운 접근이 필요하고 이에 따라 공정 개발 완성 시점이 다소 늦어질 수 있는 불리함이 있습니다. 그러나 FO-PLP가 양산화되기 시작하면 대량으로 면적 손실 없이 생산을 할 수 있기 때문에 Foundry 업체의 이익에 유리합니다. 삼성전자가 FO 양산 기술을 완성하는 시점부터 TSMC와 대등한 기회를 고객들에게 제공받을 수 있다는 전망입니다.
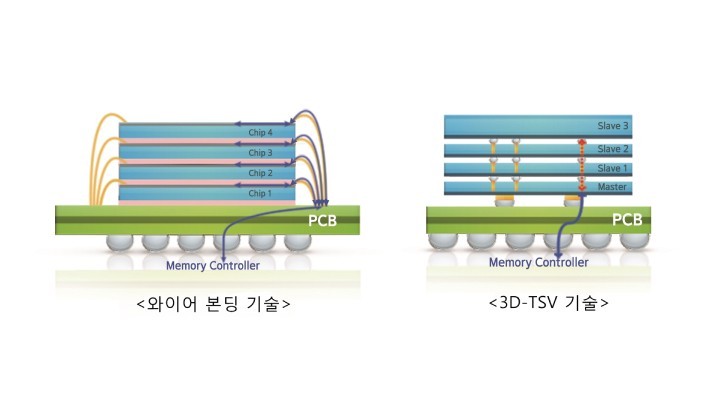
FO뿐 아니라 TSV(Through Silicon Via)라는 신규 후공정 기술도 도입되어, 후공정으로 큰 폭의 반도체 성능 개선이 이루어지고 있습니다. TSV는 패키징 할 칩을 적층 한 후, 칩들을 수직으로 관통하는 구멍을 뚫어 실리콘 관통전극으로 신호선을 연결하는 기술입니다. TSV를 본격적으로 양산화하기 위해선 완성도 높은 수율 확보가 필요하기 때문에 아직은 양산이 되지는 못하고 있습니다. TSV의 기술 진입벽이 높은 만큼, 삼성전자가 TSMC 대비 TSV 양산을 선점할 경우 Foundry 시장에서 M/S를 크게 상승시킬 수 있는 기회가 될 전망입니다.
[공부 용리 포트] 반도체 투자 처음이라면 꼭 알아야 될 기본 개념 정리 - (1) (tistory.com)
[공부용리포트] 반도체 투자 처음이라면 꼭 알아야될 기본 개념 정리 - (1)
신한금융투자_반도체_200902 Tech를 이해해야 전략이 보인다 반도체 투자가 처음이라 용어들이 낯설고 기본 개념부터 배워보고 싶다면? 이 리포트로 시작하세요. 입문자를 위하여 정말 친절하게
lhseti123.tistory.com
>>1편<<
[공부 용리 포트] 반도체 투자 처음이라면 꼭 알아야 될 기본 개념 정리 - (2) (tistory.com)
[공부용리포트] 반도체 투자 처음이라면 꼭 알아야될 기본 개념 정리 - (2)
신한금융투자_반도체_200902 Tech를 이해해야 전략이 보인다 1편을 못 보신 분들을 1편을 보고 오세요! ② NAND 반도체 기술 변화 NAND와 DRAM은 기본적인 Migration의 방식이 다릅니다. DRAM은 단순히 칩의
lhseti123.tistory.com
>>2편<<
'꼭읽어야될주식리포트 > 반도체' 카테고리의 다른 글
| [공부용리포트] 2021년 반도체가 역대급 호황인 이유? 주요 Key Point 5 가지 (20) | 2021.05.27 |
|---|---|
| [공부용리포트] 후공정 OSAT 산업의 특성과 TSMC , 삼성의 패키징 기술력의 차이 분석 (24) | 2021.05.03 |
| *5분 만에 끝내는 반도체 제조 공정 정리* (44) | 2021.04.19 |
| [반도체] DRAM, NAND, 비메모리의 기초 개념, 기술 발전 이해하기 (2) (18) | 2021.04.18 |
| [반도체] DRAM, NAND, 비메모리의 기초 개념, 기술 발전 이해하기 (10) | 2021.04.18 |




댓글